台积电尖端SoW-X封装技术将于2027年量产,计算能力比CoWoS飙升40倍
9 小时前
/ 阅读约2分钟
来源:集微网
台积电计划2027年大规模生产SoW-X封装技术,其计算能力比当前CoWoS高40倍,适用于高性能AI应用。台积电将逐步用SoW技术替代CoWoS,保持先进芯片封装领域的领先地位。

除了半导体产品发布之外,台积电还在技术研讨会上展示了先进封装技术的进展,并宣布推出SoW-X封装技术。
台积电的CoWoS先进封装技术十分重要,它基本上是英伟达等公司挑战摩尔定律以及提升性能的通常方式之一。通过将芯片集成到单个晶圆和基板上,CoWoS极大地提升了计算性能。台积电透露他们正在研发更先进的CoWoS封装技术。这包括全新改进的SoW和SoW-X版本,据称它们的性能远超现有方案。
台积电表示,他们计划从最接近的版本开始,推出一款9.5倍光罩尺寸的CoWoS版本,该版本将允许集成多达12个HBM堆栈。该版本计划于2027年投入生产,并且很可能比同期发布的其他替代方案更易成为主流封装方案。据说目前的CoWoS光罩尺寸为5.5倍(CoWoS-L),因此将光罩尺寸扩展到9.5倍对台积电来说是一项巨大的成就。
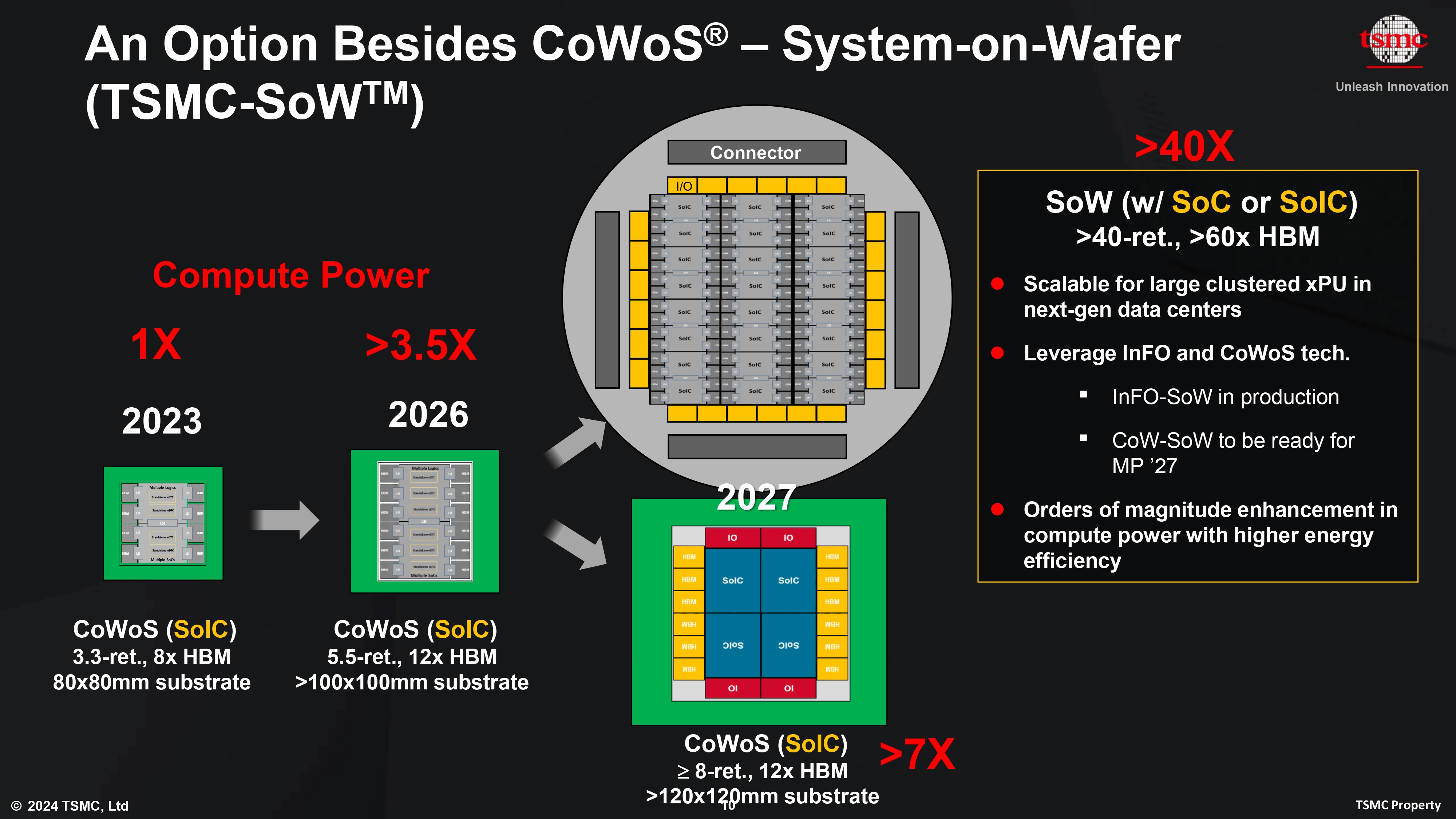
接下来,台积电计划在长远来看用其SoW(晶圆系统)方案取代CoWoS,该公司此前已经详细介绍过这项新技术。据称SoW将具备高达40倍的光罩极限以及集成60个HBM堆栈,使其成为大规模集群等AI应用的理想选择。此外,台积电还发布了一款SoW-X全新封装方案,虽然目前具体细节尚不确定,但据称该封装方案的计算能力将比当前一代CoWoS解决方案高出40倍。SoW方案预计将于2027年开始量产。
台积电已凭借其CoWoS解决方案在先进芯片封装领域占据领先地位,这家巨头计划再次称霸市场。(校对/李梅)





